1. 引言
随着技术革新与能源消耗加剧,低能耗的发展模式日益受到重视。在照明领域,LED具有节能环保、寿命长、体积小等优点,广泛应用于各种显示 [1] [2] [3] 、LCD背光源 [4] [5] 、普通照明 [6] 等领域。当基于氮化镓(GaN)材料的蓝光LED出现后,制备白光变得可行,从此发光二极管在路灯、照明等与人们生活息息相关的领域又有了更加广泛的应用。在未来,被称作第四代光源的LED将有望全面替代传统光源如白炽灯和荧光灯等。作为新一代固态光源,LED契合节能减排的发展趋势,但现今依然有着许多问题亟待解决。
GaN是直接带隙结构材料,禁带宽度可通过与其他Ⅲ族氮化物形成固溶体,使其从0.7 eV (InN)到3.39 eV (GaN),再到6.2 eV (AlN)之间连续变化,其对应的波长范围可涵盖整个可见光区(1771~200 nm)。这使得该类材料在光电子元器领域应用十分广泛 [7]。目前,GaN基LED衬底所选用的材料包括:蓝宝石、单晶硅和单晶碳化硅。相较于单晶硅和单晶碳化硅,蓝宝石所具有的优势在于:具有较好的机械性能、可靠性高、材料制备工艺成熟及易于控制等。但是,由于GaN与蓝宝石之间存在大约17%的晶格失配和大约26%的热膨胀系数失配度,因此在蓝宝石衬底上生长的GaN外延层中将存在109~1010 cm−2的位错密度 [8]。大量的缺陷导致衬底非辐射中心增多及载流子泄露加剧,使得LED的内量子效率降低。与此同时,由于GaN材料对于450 nm波长的光折射率(2.5)远大于空气的光折射率(1) [9]。有源区光子逃逸角仅约23˚,大部分的光子被限制在有源区内,致使LED的光提取率较低。无法逃逸的光子在外延层中经过一次次反射,最终以热量的形式表现出来,严重限制了LED的使用寿命。
针对这些难题,近年来发展起来的图案化蓝宝石衬底技术(Patterned Sapphire Substrate,PSS)在减少GaN外延层缺陷及提高LED出光率方面展示出很好的效果。图案化蓝宝石衬底技术是指通过特殊工艺在蓝宝石晶片表面制作具有细微结构的周期阵列图形。利用这种图案化的蓝宝石晶片作为衬底,能够有效减少由于晶格不匹配而产生的应力,同时缓解位错的产生,使得位错密度降低1~2个数量级。所获得的GaN外延层质量更高,LED的内量子效率显著提高。除此之外,高质量的GaN外延层能够减少LED工作时产生的热量,增加其使用寿命。更为重要的是,图案化蓝宝石衬底能够提高有源区光子的逃逸概率,使得光提取效率大幅度提升。
2. 图案化蓝宝石衬底提高GaN基LED出光率的作用机理
2.1. 降低GaN外延层位错密度
图案化蓝宝石衬底能够显著降低GaN外延层中的线位错密度,是由于其表面的微结构改变了GaN材料的生长过程。GaN外延层在图案化蓝宝石衬底表面生长过程的示意图如图1所示,从图1中可以看出,生长在衬底图案之间的平面区域内的GaN材料,其位错会向上延伸至外延层表面,但是在衬底图案侧面上生长的GaN材料,其位错方向发生90˚弯曲,则位错线将不能达到外延层表面,从而有效降低GaN外延层表面的位错密度。较低的位错密度使得有源区的非辐射复合中心减少,缓解了载流子散射,从而提高了内量子效率。值得注意的是,图形侧面区域的面积对于位错密度有着较大影响,相较于梯形图案化蓝宝石衬底,圆锥形图案化蓝宝石衬底具有更大比例的侧面,因此更有助于抑制外延层表面的线位错。

Figure 1. Schematic diagram of GaN epitaxial layer dislocations grown on the surface of [9] : (a) trapezoidal PSS, (b) tapered PSS
图1. 图案化蓝宝石衬底表面生长GaN外延层的位错示意图 [9] :(a) 梯形图形化蓝宝石衬底;(b) 锥形图形化蓝宝石衬底
同样地,增加图案的密集程度也有助于提高侧面区域的比重,从而减少位错,因此,图案化蓝宝石衬底有助于高质量GaN外延层的生长。图2展示了普通蓝宝石衬底与图案化蓝宝石衬底上外延GaN材料的位错情况。可明显看出,生长在图案化衬底上的外延层,其缺陷明显少于生长在普通蓝宝石衬底上的外延层。
2.2. 增加光提取率
与此同时,图案化蓝宝石衬底有助于LED增加光提取率,其原理如图3所示,由于衬底表面微结构的存在,原本可能被限制于有源区的光子通过蓝宝石衬底的多次反射,改变了传播路径,当角度处于逃逸角范围内时,光子便成功逃逸,因此,图案化的蓝宝石衬底能够增加光子的逃逸概率,使得LED光提取率增加。

Figure 2. Cross section of GaN epitaxial layer under TEM [10] : (a) on PSS, (b) on ordinary sapphire substrate
图2. TEM下的GaN外延层截面 [10] :(a) 图案化蓝宝石衬底;(b) 普通蓝宝石衬底
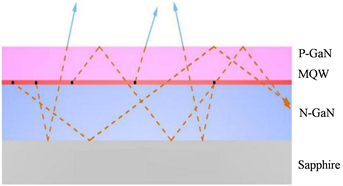 (a)
(a)  (b)
(b)
Figure 3. Photon motion paths in GaN epitaxial layers on different substrates: (a) ordinary sapphire substrate, (b) PSS
图3. 不同衬底上GaN外延层中光子运动路径:(a) 普通蓝宝石衬底;(b) 图案化蓝宝石衬底
3. PSS表面微结构对LED发光效率的影响
为提高图案化蓝宝石衬底的性能,国内外学者从表面微结构的几何参数入手,进行了大量的研究 [9] [10] [11]。基于图案化蓝宝石衬底提高LED出光效率的原理,图案的几何参数对出光率的影响同样包含了对外延层生长质量以及光传播路径的影响。所谓的几何参数包含了图形的几何形状及图形尺寸。
3.1. 几何形状对LED发光效率的影响
外延层生长质量与成核点的多寡有着密切关系,成核区越小、成核点数量越少,就越有利于外延层横向生长,从而减少位错密度。由于GaN薄膜在生长过程中最易在蓝宝石的C面成核,因此,图案化蓝宝石衬底技术发展至今,其微观图形的几何形状由简单向复杂化的趋势演变;从最初的沟槽状,到柱状,再到台状,最后达到当前常见的半球状和圆锥状;每一次形状的改变,本质上都是在尽可能地减少C面面积以缩小成核区、降低成核点数量。
如图4所示,以沟槽状图形为例,沟槽位置不利于外延层的生长,GaN于未刻蚀处成核,通过调整生长工艺参数,促进GaN横向生长,最后外延层逐步接合。外延层与蓝宝石衬底的接触面积变小,因此也在一定程度上减少了因晶格失配与热失配产生的位错。与此同时,与C面成一夹角的侧面的存在,也大大增加了光线在外延层内通过反复反射和折射最终满足逃逸角度要求的几率。
同样的,各种不同几何形状的微结构减少外延层生长缺陷与增加光逃逸几率的机理均与沟槽状结构类似,其中半球状和圆锥状结构将图形区域的C面面积降至最低,极大程度地减少了外延生长的成核点数量,理论上显著地避免了位错发生,同时由于表面为曲面,大大增加了光通过反射达到逃逸角度的几率,因此成为当下使用最广泛的衬底图形。
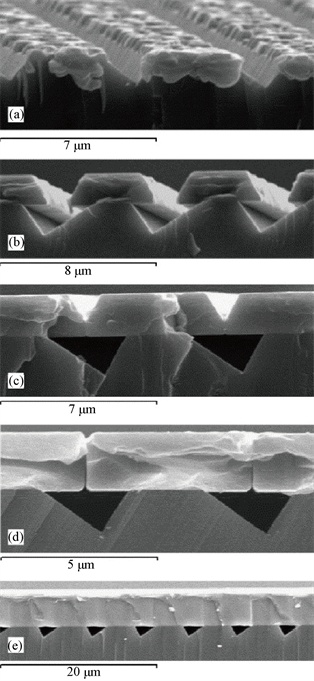
Figure 4. SEM cross section of different stages of GaN epitaxial layers growth of on a grooved pattern sapphire substrate [10]
图4. 沟槽状图形衬底上GaN横向外延生长不同阶段的断面SEM图 [10]
3.2. 图形尺寸对LED发光效率的影响
在图案化蓝宝石衬底发展的初始阶段,对图形的研究停留在微米尺度,随着纳米技术的发展,对衬底图形的研究也朝着纳米级发展。大量研究表明,纳米级图案化蓝宝石衬底(NPSS)在不论从外延层生长质量或是光逃逸效率,对于微米级图案化蓝宝石衬底(MPSS)均具有优势。原因在于随着图形尺寸的缩小,衬底与外延层之间更易产生空隙,从而进一步地降低衬底与外延层的接触面积,使得晶格失配与热失配产生的外延层位错更少,如图5所示,NPSS外延时产生的空隙密度远远大于MPSS。除此之外,由于单位面积内所具有的斜面更多,所以光在外延层中有更大几率射出。图6为器件效率与注入电流之间的关系图,在注入电流0~100 mA范围内,MPSS的期间效率始终高于NPSS。综上所述,图形尺寸的减小,有助于提高外延层质量、提高出光效率。

Figure 5. SEM cross section of GaN epitaxial layer [12] : (a) on a MPSS, (b) on a NPSS
图5. 图形衬底上外延GaN薄膜的断面SEM图 [12] :(a) MPSS;(b) NPSS

Figure 6. Relationship between light output power and injection current of LED devices prepared on ordinary substrates, MPSS and NPSS [12]
图6. 普通衬底、微米和纳米图形衬底上制备的LED器件光输出功率与注入电流关系图 [12]
4. 图案化蓝宝石衬底的制备过程
图案化蓝宝石衬底的制备包含两个关键过程,一是掩膜制备,二是掩膜图形的转移。掩膜制备是指在蓝宝石衬底晶片上制备出带有周期性图案的掩膜图形,用于保护图形下的蓝宝石晶片;掩膜图形的转移是指将掩膜的图形转移到蓝宝石衬底上,在蓝宝石衬底上制作出周期性图案。
4.1. 掩膜制备
4.1.1. Ni掩膜
Ni是最常用于掩膜制备的金属材料,通常是在蓝宝石表面离子束蒸镀一层几百微米厚的金属膜作为刻蚀掩膜,然后通过光刻工艺制备出图案化的Ni掩膜,其图案和尺寸取决于掩膜板 [13]。
4.1.2. SiNx掩膜
利用等离子体增强化学气相沉积技术(Plasma Enhanced Chemical Vapor Deposition,PECVD)在蓝宝石衬底上沉积一层SiNx薄膜作为刻蚀掩膜,通过有机玻璃(即聚甲基丙烯酸甲酯,PMMA)在深紫外灯定位器下制作阵列图形,再利用回流技术缩小图间距离,最后通过反应离子刻蚀将图形转移至SiNx掩膜 [14]。
4.1.3. SiO2掩膜
利用等离子体增强化学气相沉积技术沉积一层SiO2薄膜 [15] [16] [17],再通过标准光刻工艺和刻蚀技术制作图形化SiO2掩膜 [18] [19]。通常是采用电感耦合等离子体(Inductively Coupled Plasma,ICP)对未保护的SiO2薄膜进行去除,从而在SiO2掩膜上制备图形 [20] [21]。特别地,若在SiO2薄膜上涂布单层纳米球,则可用于制作纳米级图形化蓝宝石衬底的掩膜图形 [20]。除了ICP,也可通过缓冲氧化刻蚀剂(Buffered Oxide Etch,BOE)在制作图形化SiO2 [14]。
4.1.4. 光刻胶掩膜
在蓝宝石衬底表面旋涂一层几微米厚的光刻胶,通过前烘、对准、紫外光曝光、烘焙、显影等步骤将掩膜板上的图形复制到光刻胶上,再以图案化的光刻胶薄膜为掩膜进行刻蚀或是离子注入后得到图案化蓝宝石衬底。
4.2. 图形的转移
刻蚀技术是半导体领域常用的一种去除材料的手段,利用化学反应或是物理碰撞等方式来达到移除目的。图形的转移是指,蓝宝石衬底在掩膜的选择性保护下进行刻蚀,最终在蓝宝石衬底表面得到与掩膜图案相对应的微观图形。刻蚀技术又大致可分为干法刻蚀和湿法腐蚀两种。
4.2.1. 干法刻蚀
图案化蓝宝石衬底干法刻蚀基于高密度等离子体刻蚀工艺,通过偏置电场下的等离子体轰击衬底,并与衬底材料发生化学反应来达到去除目的,根据反应方式的不同,干法刻蚀可分为物理轰击刻蚀、化学反应刻蚀和物理、化学复合刻蚀三种 [13]。
物理轰击刻蚀是指带电正离子在偏置电场中加速撞击衬底表面,经由部分离子能量将衬底材料击出,被击出材料在低压下由真空抽离系统带走。由于该方法属于物理去除方法,由于缺乏对材料的选择性,常常会造成衬刻蚀处底晶格损伤,如图7(a)所示。化学反应刻蚀是利用等离子体中的反应气体与衬底材料发生化学反应生成易挥发生成物的原理来达到去除目的,具有较好的选择性。刻蚀气体经过等离子化增强其反应活性,经扩散达到衬底表面进行等向刻蚀,生成的易挥发物质经气泵抽离,但生成的难挥发物质将沉积于衬底表面,使得反应效率逐步降低。化学反应刻蚀的工作机理如图7(b)所示。
物理、化学复合刻蚀如感应耦合反应粒子刻蚀等技术,基本上是物理方法与化学反应的结合,这种方法兼具对材料的选择性和刻蚀的方向性,其原理如图7(c)所示。先由高速离子撞击衬底表面使得衬底材料表面晶格损伤、Al-O键断裂,导致材料表面化学活性增加,随后,衬底材料与刻蚀气体发生反应,易挥发生成物挥发逃逸而难挥发生成物经由高速离子轰击持续抛出,使得化学反应能够继续进行。
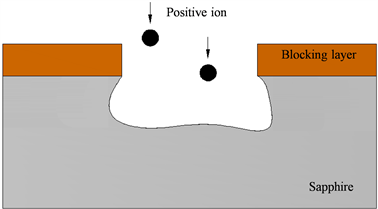 (a)
(a) 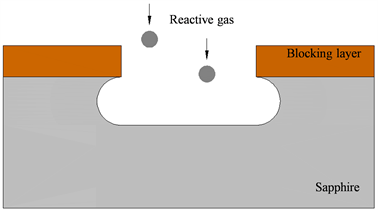 (b)
(b) (c)
(c)
Figure 7. Principles of dry etching: (a) physical bombardment etching, (b) chemical reactive etching, (c) physical and chemical composite etching
图7. 干法刻蚀:(a) 物理轰击刻蚀;(b) 化学反应刻蚀;(c) 物理、化学复合刻蚀
蓝宝石衬底干法刻蚀通常使用氯基、溴基与氟基气体作为主要的刻蚀气体。常以光刻胶 [22] [23] [24] 作为掩膜,另外也可用SiO2或Ni作为掩膜材料。卤素气体与蓝宝石(Al2O3)反应的产物主要是AlCl3,AlB3与AlF3 (沸点分别是178℃,263℃与1297℃)等。图案化蓝宝石干法刻蚀广泛使用BCl3或BCl3-Cl2作为主要刻蚀气体,其他的工艺气体组合还有BCl3-HBr、BCl3-HCl、BCl3-SF6、I2、CH2Cl2-Cl2等,辅气有N2,AR2等 [23]。
以BCl3气体为例,蓝宝石衬底干法刻蚀的化学反应过程如下:
4.2.2. 湿法腐蚀
湿法腐蚀是采用化学溶剂通过化学反应的方式来达到去除材料的目的,经过将晶片浸泡于刻蚀溶液或是将溶液喷洒于晶片表面,使两者接触并发生化学反应来移除材料,如图8所示。湿法腐蚀的优势在于方法简单、速度快。湿法腐蚀的材料去除机理包含三个步骤:a) 反应物通过扩散方式到达晶片表面;b) 表面结合发生化学反应;c) 产生生成物并以扩散方式离开晶片表面。对于既定的材料,通常可以有针对性地找到一种刻蚀剂能够对该材料进行快速刻蚀,而同时不伤害到其他材料,因此,湿法腐蚀对于材料有着较高的选择性。同时,由于化学反应并不存在特定方向,所以湿法腐蚀又缺乏方向性,在纵向刻蚀的过程中同时也会有横向的刻蚀效果 [25]。
图案化蓝宝石衬底湿法刻蚀所用溶液通常为H2SO4与H3PO4的混酸体系,刻蚀时溶液温度在240℃~320℃范围,因此湿法刻蚀通常采用SiO2、SInx或Ni作为掩膜,湿法刻蚀主要反应方程如下 [25] :
由于更易于控制,干法刻蚀是目前最常见的生产PSS晶片的方法,高度统一和密集的圆拱形微结构非常有助于外延薄膜横向生长、减少位错密度和增加出光率。然而干法刻蚀是一个非常缓慢的过程,其效率大概仅有每分钟50~200 nm。且干法刻蚀工艺亦较难以实现效率、产量的提升,随着衬底尺寸的增大,干法刻蚀机台的产量随着真空室内衬底数量的减少而下降,因此扩大产能,就意味着更多的设备、维护和消耗品等的投入。这无疑将成为干法刻蚀持续发展的瓶颈。与此同时,由于干法刻蚀的刻蚀机理主要为物理轰击,这便不可避免地使得微观图形表面产生损伤,降低PSS增加出光率的能力。
相反,湿法蚀刻工艺在加工速率、成本和可扩展性方面比干蚀刻工艺更有优势。例如,一批6英寸衬底的工艺槽,其成本仅比为一批2英寸衬底设计的槽体稍多一点,而且能容纳相同数量的衬底;并且在正确的条件下,其移除速率可高达1 μm/min。因此许多学者相信,湿法刻蚀将在在LED大规模生产中扮演关键的成本降低角色。当然,湿法刻蚀同样存在许多问题,首先,极端活泼的化学物质会对设备和人员的安全构成威胁。其次,由于腐蚀作用的各向同性使得刻蚀过程中出现横向腐蚀,也就是所谓的“undercut”现象,因此对于湿法刻蚀来说,图形宽度的控制是工艺过程中需要挑战的一个难点。最后,由于湿法刻蚀对于材料的选择性的影响,衬底被掩膜保护的部分腐蚀程度较小,所以最终形成的图形通常带有顶部平面,如图9(a)所示。顶部平面阻碍了薄膜的横向生长,促进了薄膜的垂直生长,从而增加了外延缺陷的数量,同时平面面积的增加将抑制光的有效折射。对此,甚至有相关研究人员开发出了一种方法来打磨顶部平面,使其变得圆滑、更接近于干法刻蚀所形成的微结构,如图9(b)所示。
 (a)
(a) (b)
(b)
Figure 9. Micrographs of PSS prepared by different methods [26] : (a) wet etching, (b) dry etching
图9. 不同方法制备的PSS的微观图形 [26] :(a) 湿法刻蚀;(b) 干法刻蚀
总而言之,干法刻蚀更容易获得圆滑的顶部,因此不论是从外延层质量,到出光效率,其性能都更加优异,但是干法刻蚀的刻蚀效率有限。而湿法刻蚀却拥有极高的效率,倘若能够克服图形宽度控制和顶面圆滑化的技术难点,湿法刻蚀将在今后LED大规模生产中发挥巨大的效应。
5. 总结
图案化蓝宝石衬底技术是一种能够有效减少GaN基外延层位错密度、提高内量子效率的新技术。从衬底层面来讲,影响LED出光效率的因素包含其表面微结构的几何形状和尺寸。特别是缩小尺寸,形成纳米级图案化蓝宝石衬底能够显著地提高LED的出光效率,毫无疑问,纳米级图案化蓝宝石衬将是未来图案化蓝宝石衬底发展的重点方向。在PSS制备方面,干、湿法刻蚀具有各自的优点,但是从制备效率而言,湿法刻蚀更具备大规模生产的潜力,但是如何控制图形的宽度、怎样高效地获得更加圆滑的图形是湿法刻蚀工艺下一步需要挑战的关键难题。
NOTES
*通讯作者。