1. 引言
多层膜光学元件被广泛应用于天文观测 [1]、同步辐射 [2]、半导体 [3]、显微成像 [4]、等离子体诊断 [5] 和极紫外(EUV)光刻 [6] 等诸多领域。随着光刻技术的快速发展,EUV光刻已进入7 nm和5 nm技术节点电子器件大规模生产的时代 [7]。EUV光刻采用的13.5 nm光辐射极易被绝大多数材料吸收,因此EUV光刻采用反射式光学系统和反射式掩模结构,反射式光学系统的物镜和反射式掩模表面镀有周期厚度纳米级的多层膜,可实现较高的光反射率 [8] [9]。多层膜缺陷是EUV光刻掩模特有的缺陷,对光刻工艺的良率影响极大,由于设备与工艺水平的限制,目前无法制造无缺陷掩模,于是掩模缺陷的及时检测至关重要 [10]。由于多层膜材料的穿透深度和多层膜的光反射率很大程度上取决于波长,因此,在波长掩模缺陷检测工具是不可或缺的 [11]。
EUV多层膜由高低原子序数的材料交替组成,如Mo/Si多层膜就是EUV波段最为成功的一种多层膜,其几何周期厚度具有良好的时间稳定性,而且可使13.5 nm附近的EUV光实现近70%的最高反射率 [12] [13] [14] [15]。Mo/Si多层膜由实验测得的实际反射率远低于理想结构的理论值,这是由于在Mo层和Si层的界面处形成了硅化物 [16]。有研究表明,Mo/Si多层膜的高反射率特性受到多层膜界面的巨大影响,尤其取决于界面膜层的厚度和化学组分 [17]。因此,多层膜的实际应用必须考虑膜层间的扩散,而Mo/Si多层膜的膜系结构可分为两种,一种是二层模型,即仅考虑Mo层和Si层;另外一种是四层模型,该模型不仅考虑Mo层和Si层,还考虑两层之间的MoSi2扩散层 [18]。
由于多层膜的反射是由各膜层反射光线干涉形成,因此现有的光学设计软件无法模拟多层膜的反射特性,这意味着光学设计软件无法分析由多层膜引入的相位和振幅变化,相位的变化会引起反射光的波前变化和传播方向的相应偏移,进而影响系统的成像质量,因此在成像系统的优化过程中必须考虑多层膜的影响。Bal等人 [19] 基于此提出了有效入射深度模型,即用位于一定深度的单个有效入射表面替代多层膜,推导了有效入射深度与入射角、膜层参数的函数关系,但是当入射角较大时,p偏振光和s偏振光的有效入射深度差别很大。王君等人 [20] 基于能量守恒定律构造了等效工作界面模型,将多层膜等效为一个与之有相同光学性能的单一表面,使基于多层膜引入相位变化的等效工作面模型适用于大角度入射。但是,已有研究运用的多层膜未考虑膜层界面处原子间的扩散和化合反应,这意味着成像系统考虑多层膜的优化结果与实际存在较大的偏差。同时,基于传统光学设计方法获得的最佳反射面应该是多层膜和裸镜面形共同作用的结果,而对于此的EUV光刻掩模缺陷检测系统的优化设计还有待进一步研究。
为了保证基于Schwarzschild结构的EUV光刻掩模缺陷检测系统的成像质量,本文提出了分别优化设计多层膜和裸镜面形的方法。基于多层膜等效工作界面模型 [20],首先介绍了四层模型的等效工作面计算方法;然后设计优化了非球面Schwarzschild放大成像系统考虑多层膜的初始结构;通过分析多层膜反射镜的光线入射角范围,设计反射镜的多层膜周期厚度分布;最后计算得出适合多层膜系统的裸镜面形。
2. 等效工作面模型
2.1. 光学薄膜特性理论
薄膜的特征矩阵可以方便地表示光学多层膜系统的特性,对于多层膜系而言,基于每个界面运用电磁场的边界条件,并在同一膜层中,采用光波传播过程中的相位关系,得到含有k个膜层的多层膜系矩阵方程 [21] [22]
(1)
(2)
(3)
其中,
为第j层薄膜的特征矩阵,
为基底的光学导纳,
是光波在第j层薄膜中的有效相位厚度,i为虚数单位,
是光波在第j层膜的有效光学导纳,
为膜层的几何厚度,
为入射角,
为工作波长。通过式(1),求解多层膜膜系的等效光学导纳Y及相应波长处的多层膜表面反射率R为:
(4)
(5)
其中
是入射介质的导纳。多层膜透射率T为:
(6)
2.2. 等效工作面理论
Mo/Si多层膜在13.5 nm附近波段可实现较高的反射率,研究表明,反射率受Mo膜层和Si膜层之间扩散层的影响较大,所以一般采用如图1所示的一周期Mo/Si多层膜的四层模型结构。Mo层在Si层上的MoSi2扩散层厚度与Si层在Mo层上的MoSi2扩散层厚度相比,前者的厚度较大,这归因于Mo的表面自由能比Si高,Mo原子向Si层的扩散比Si原子向Mo层的扩散率高。
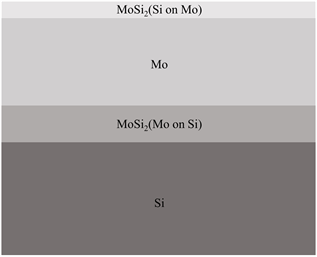
Figure 1. Schematic diagram of the four-layer model structure of a one-period Mo/Si multilayer
图1. 一周期Mo/Si多层膜的四层模型结构示意图
图2为多层膜等效工作面示意图,基于能量守恒原理将多层膜等效为单一表面,该表面与多层膜具有相同的光学特性(反射率、透射率及吸收),多层膜顶部与等效工作面的距离为多层膜有效入射深度,因此等效工作面与反射镜表面的距离为多层膜附加厚度。设处于有效入射深度内的膜层对光强的衰减系数为
[20],其可计算为:
(7)

Figure 2. Schematic diagram of equivalent working surface model
图2. 等效工作面模型示意图
同时根据电磁场理论有 [20]
(8)
式中
为等效工作面距多层膜表面的垂直厚度,即有效入射深度,z为原点位于多层膜表面,并垂直于多层膜表面的坐标,k为光学薄膜中经入射角
调制后的消光系数分布。根据式(7)和式(8),求解得到有效入射深度
。考虑膜层间多次反射情况下的等效入射界面更准确的位置
(9)
式中
为膜层间的反射率。
(10)
式中
为多层膜表面介质在入射介质中的反射率。D即所求的光在多层膜中的有效入射深度。
3. 考虑多层膜的系统裸镜面形计算
裸镜系统面形的计算流程如图3所示,首先基于传统光学设计方法,在不考虑多层膜效应的前提下,对基于Schwarzschild结构的EUV光刻掩模暗场检测系统进行设计优化,获取理想成像面形,即多层膜反射镜的等效最佳工作面;然后获取反射镜的入射角范围,根据入射角分布进行主次镜多层膜设计;根据能量守恒原理计算多层膜附加厚度,即等效工作面到裸镜的距离;最后通过最小二乘法获取裸镜面形。

Figure 3. Flow chart of bare mirror shape calculation
图3. 裸镜面形计算流程图
3.1. 考虑多层膜的光学系统设计优化
EUV光刻掩模缺陷暗场检测系统采用如图4所示的Schwarzschild结构,系统采用全反射式结构。反射镜均采用8阶偶次非球面,主镜M1为凹面反射镜,次镜M2为凸面反射镜,反射镜关于光轴旋转对称。系统的具体参数如表1所示。

Figure 4. Dark-field detection system for extreme ultraviolet lithography mask defects
图4. EUV光刻掩模缺陷暗场检测系统

Table 1. System resulting data of standard experiment
表1. Schwarzschild放大系统主要参数
基于光学设计理论,对系统进行优化,针对典型视场调制传递函数(MTF)进行优化,以保证全视场具备良好的像质。调整结构,优化布局,将系统光阑设置在主镜前端,反射镜的口径决定系统的外形尺寸,控制主镜与次镜的间隔和口径,协调光路折叠方式,使结构合理。优化后的反射镜面形为考虑多层膜的理想成像面形,即为多层膜与裸镜面形共同作用的结果。从图5所示的全视场RMS波像差可以看出,全视场的波像差优于
(
= 13.5 nm),波像差满足成像要求。MTF是成像质量评价的重要参数之一,系统经过优化后的MTF曲线如图6所示,可见全视场MTF曲线均达到衍射极限水平。

Figure 5. RMS wave aberration of Schwarzschild system
图5. Schwarzschild系统的RMS波像差
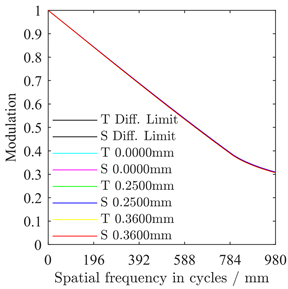
Figure 6. MTF curve of Schwarzschild system
图6. Schwarzschild系统的MTF曲线
3.2. 对比分析二层模型与四层模型对系统成像质量的影响
以3.1节Schwarzschild系统为例,量化四层模型与二层模型对系统成像质量影响的差异。在图7中,图7(a)和图7(b)分别为系统镀制二层模型和四层模型多层膜后的MTF曲线,可以看到成像质量均下降很大。系统镀制不同膜系结构多层膜优化后的MTF曲线如图8所示,在镀制二层模型多层膜时,仅优化物像距系统成像质量便可恢复衍射极限水平;而镀制四层模型多层膜时,同等优化条件下,系统成像质量不能恢复到衍射极限水平。因此,考虑到四层模型更接近实际膜系结构,分析多层膜对系统成像质量的影响时,应用四层模型是必要的。
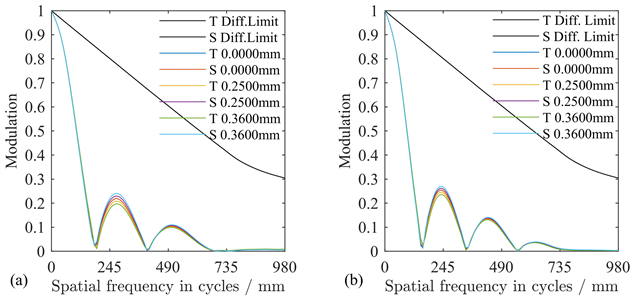
Figure 7. The MTF curve of the system after coating the multilayers with different film structure. (a) Two-layer model; (b) Four-layer model
图7. 系统镀制不同膜系结构多层膜后的MTF曲线。(a) 二层模型;(b) 四层模型
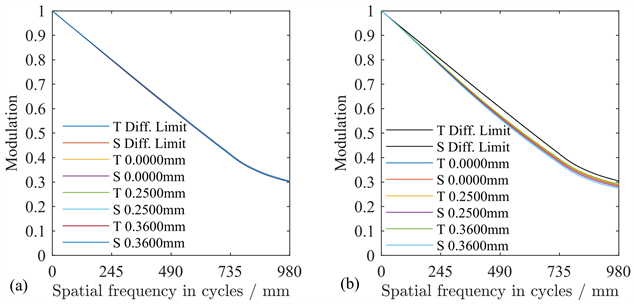
Figure 8. The optimized MTF curve of the multilayers system with different film structure. (a) Two-layer model; (b) Four-layer model
图8. 系统镀制不同膜系结构多层膜优化后的MTF曲线。(a) 二层模型;(b) 四层模型
3.3. 主次镜多层膜设计
为进行系统中主次镜多层膜设计,对光学系统采用光线追迹方法进一步分析,得到主次镜的光线入射角分布为2.04˚~3.81˚和5.16˚~11.86˚,次镜光线入射角范围超过10˚。为了保证多层膜反射镜在超过10˚入射角范围内对13.5 nm的EUV光达到高反射率,在主镜上设计均匀多层膜,在次镜上设计梯度多层膜。Mo/Si多层膜共40个周期,在设计梯度多层膜时,由于MoSi2扩散层厚度很薄,并且不依赖于Mo层或Si层的厚度,因此将扩散层的几何厚度理想化处理,近似认为扩散层的厚度不变,令Mo层在Si层上和Si层在Mo层上的MoSi2扩散层厚度分别为1 nm和0.5 nm。固定两个MoSi2膜层厚度,改变四层模型中Mo层和Si层的几何厚度,其中Mo层的几何厚度分布范围为2.27 nm~2.31 nm,Si层的几何厚度分布范围为3.15 nm~3.21 nm。多层膜膜厚分布如图9所示,分别给出了主次镜多层膜膜厚随物镜口径的变化。
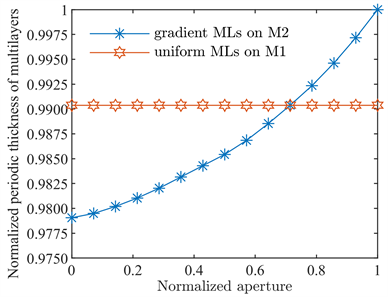
Figure 9. The change curve of the period thickness of the normalized multilayers with the diameter of the normalized mirror
图9. 归一化多层膜周期厚度随归一化反射镜口径的变化曲线
3.4. 主次镜多层膜附加厚度计算
基于式(7)和式(8),对多层膜等效工作面附加厚度进行计算,主镜的均匀多层膜附加厚度为231.65 nm;次镜的梯度多层膜附加厚度分布如图10所示,彩色条给出了沿光轴的附加厚度大小,正负代表多层膜附加厚度在全局坐标中相对等效工作面位置的走向。

Figure 10. Additional thickness distribution of gradient multilayers of secondary mirror M2
图10. 次镜M2的梯度多层膜附加厚度分布
4. 裸镜面形结果分析
系统两裸镜的表面类型均选用8阶偶次非球面,利用最小二乘法对由多层膜反射镜反演得到的裸镜面形进行拟合。表2展示了拟合所获得的两裸镜的中心曲率半径、二次曲面常数和高次非球面系数,以及传统设计方法得到的裸镜面形信息,对比两种方法获得的裸镜面形,可知主镜M1的裸镜面形相同,次镜M2的裸镜面形不同,产生这种结果的原因是主镜M1镀制均匀膜后面形不发生改变,而次镜M2镀制梯度膜后面形发生了改变。另外拟合精度对结果也有重要影响,主次镜的裸镜面形拟合误差(Root mean square error-RMSE)分别为2.0697 × 10-14 mm和3.3263 × 10-8 mm,拟合精度较理想。

Table 2. Fitting results of bare mirror surface of the system with multilayers
表2. 考虑多层膜的系统裸镜面形拟合结果
图11给出了按照偶次非球面方程拟合得到的系统两裸镜的三维面形图,如图所示,两裸镜均为中心挖孔的旋转对称非球面镜。以表面中心点为坐标原点,彩色条给出了各点的矢高值,可以得出主镜的裸镜边缘矢高为−19.9947 mm,次镜的裸镜边缘矢高为−2.6982 mm。

Figure 11. The three-dimensional surface figure of the primary mirror and the secondary mirror of the system with multilayers. (a) The naked mirror shape of the primary mirror (M1); (b) The naked mirror shape of the secondary mirror (M2)
图11. 考虑多层膜的系统主次镜的裸镜三维面形图。(a) 主镜(M1)的裸镜面形;(b) 次镜(M2)的裸镜面形
非球面光学表面是通过多个加工、检测、再加工的循环完成的,以子午曲面方程所决定的表面类型和制造精度为基础,判断设计的非球面镜是否适用于目前的加工检测 [23]。非球面最主要的特性是非球面度,非球面度是非球面与最佳比较球面的偏离量,即精加工需要去除的量,这个值决定了加工非球面的方法。非球面的面形梯度即非球面与最佳比较球面偏离量的切线斜率值,主要反映加工和检测的难度 [24]。在子午面内,对不同裸镜沿y轴方向的偏离量每隔0.1 mm采样,计算得到考虑多层膜的系统两裸镜的面形梯度曲线如图12所示,主镜的裸镜最大面形梯度为5.9 μm,次镜的裸镜最大面形梯度为10.2 μm,表示主次镜的裸镜非球面对于最佳比较球面的偏离量在子午曲线上1 mm弧长内分别增大5.9 μm、10.2 μm,适用于目前的加工检测。将图12中次镜M2的面形梯度与图13中未考虑多层膜得到的裸镜面形梯度进行对比,发现两者的面形梯度在微米量级上数值相同。
在图14中,通过表面矢高的差别,分析传统设计方法和多层膜反射镜反演方法获得的次镜M2的裸镜面形之差别,可以看出,两者的矢高差随反射镜口径的增大而增大,最大差别约为7 nm。
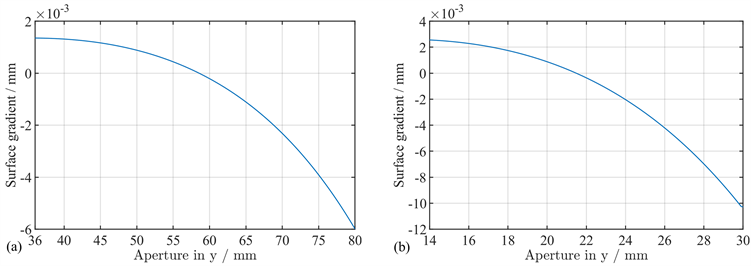
Figure 12. The surface gradient of the bare mirror of the primary and secondary mirrors of the system with multilayers. (a) The surface gradient of the primary mirror (M1); (b) The surface gradient of the secondary mirror (M2)
图12. 考虑多层膜的系统主次镜的裸镜面形梯度。(a) 主镜(M1)的裸镜面形梯度;(b) 次镜(M2)的裸镜面形梯度

Figure 13. The surface gradient of the secondary mirror (M2) of the system without multilayers
图13. 不考虑多层膜的系统次镜(M2)的面形梯度

Figure 14. The difference between the secondary mirror (M2) of the system with multilayers and without multilayers changes with the diameter of the mirror
图14. 考虑多层膜与不考虑多层膜的系统次镜(M2)裸镜面形之差随反射镜口径的变化
5. 结论
本文介绍了综合分析多层膜等效工作面和裸镜基底面形的光学系统设计方法,首先设计优化了基于Schwarzschild结构的EUV光刻掩模缺陷暗场检测系统,系统采用双非球面反射镜,数值孔径NA为0.5,全视场MTF曲线达到衍射极限水平。然后利用等效工作面原理,对考虑了MoSi2扩散层的Mo/Si多层膜进行等效工作面计算,获得不同反射镜的多层膜附加厚度。最后通过最小二乘法拟合得到裸镜面形,其中主镜的裸镜面形拟合误差(RMSE)为2.0697 × 10−14 mm,次镜的裸镜面形拟合误差为3.3263 × 10−8 mm,拟合精度理想。通过计算不同裸镜面形梯度,得到主镜的裸镜最大面形梯度为5.9 μm,次镜的裸镜最大面形梯度为10.2 μm,适合加工检测。这种通过理想系统多层膜反射镜推算裸镜面形的方法具有较强的实用性和良好的应用前景。
基金项目
吉林省科技发展计划项目(No.20200401052GX)。
NOTES
*通讯作者。