1. 引言
近年来,人工智能技术的发展推动了半导体产业的进步,现代电子器件的性能和功能不断提高以满足人们对时代发展的需求。新型器件的研究成为了研究者们所追求的新方向 [1] [2] ,而新型器件的性质和功能往往取决于材料间的耦合,利用材料的独特性质增强新器件的功能,一定程度上说,对于器件的研究开发就是对材料耦合界面的研究开发。在传统的相干耦合中,内部场 [3] [4] 往往会引起斯托克斯效应或斯塔克效应,例如在Al2O3(0002)上生长的GaN膜会沿生长方向出现内场,这严重影响薄膜的量子效率。而结合不同结构的相材料例如P. Waltereit等人 [5] 在具有立方相的(001) LiAlO2衬底上制备具有六方相的高质量GaN膜时,可以避免这种效果,在LiGaO2和LaAlO3衬底 [6] [7] 上生长时,也可以得到类似的结果。这激发了研究人员在许多独特材料中制造各种组合,与GaN材料特性相似,ZnO作为第三代宽禁带半导体具有诸多优点,例如更宽的带隙(~3.4 eV) [8] ,更高的自由激子束缚能(~60 meV),优异的压电系数 [9] ,材料环保性好等。而MgO作为典型的立方材料,是很多材料的良好衬底,H. Zhou等人在MgO [10] [11] 等立方相衬底上制备了具有各种生长取向的ZnO薄膜。然而,ZnO薄膜在这类组合中具有因为较大的失配和相结构不对称性而出现极其复杂的生长行为,很容易受到基底和制备条件的影响而产生不同的生长取向。因此,如何精确控制这些薄膜生长是一个巨大的挑战。
2. 实验方法
ZnO薄膜的生长主要通过Omicron公司制造的超高真空分子束外延(UHV-MBE)和扫描探针显微镜(Scanning Probe Microscopy, SPM)的联合系统完成,生长所用衬底为合肥科晶材料技术有限公司生产的MgO(110),衬底粗糙度小于0.5 nm。通过原子力显微镜(AFM,日本精工株式会社SPA-400)表征其表面形貌,并采用紫外可见光谱(UV-VIS,美国PerkinElmer LAMBDA 750)研究了其光学性质,X射线衍射(XRD,荷兰Philips PANalytical X Pert PRO)用于研究生长特性和界面结构。这项工作旨在丰富对六方相和立方相之间耦合的理解,为在立方相衬底上制备ZnO薄膜提供参考。用分子束外延方法时,由于在蒸发过程中,衬底和薄膜表面受残余气体分子或原子的轰击次数较少,大约1013次/cm2∙s,因此,杂质气体掺入到薄膜中的可能性较小;而且MBE的生长速率慢,一般为0.1~10个单原子层/s,容易得到光滑均匀的表面和界面;可以比较精确地控制基底和源的温度,更容易生长出高质量的薄膜。首先将MgO(110)衬底分别在丙酮和乙醇中各超声波清洗三次以去除表面杂质,每次为5分钟,之后使用去离子水洗去酒精并使用干燥氮气吹干。然后引入MBE生长室(超高真空环境,基础气压为10−7 Pa),为了获得理想的原子表面,MgO(110)衬底在生长前需要在500℃下高温退火一小时,退火时射频等离子体源的功率设定为250 W,氧分压保持在5.0 × 10−3 Pa,退火处理使得衬底表面更加平整易于ZnO薄膜生长。为了探究氧分压对所生长ZnO薄膜的影响,在保证其他条件不变的情况下,使五组样品的氧分压分别保持在0.6 × 10−3 Pa,1.0 × 10−3 Pa,1.5 × 10−3 Pa,2.0 × 10−3 Pa和5.0 × 10−3 Pa,依照氧分压由低到高分别命名为样品a、样品b、样品c、样品d和样品e。生长时使束源炉的锌源温度(纯度99.999%)保持在340℃,衬底温度240℃,等离子体源功率为180 W,生长时间设定为1小时。
3. 实验结果与讨论
图1为在MgO(110)衬底上外延ZnO薄膜的AFM测试表征结果。从图中可以看出样品在氧压为0.6 × 10−3 Pa图1(a)和1.0 × 10−3 Pa图1(b)时明显比其他富氧环境下生长的样品表面颗粒更小;1.5 × 10−3 Pa图1(c)的样品c较图1(a),图1(b)有着更小的晶粒,但同时也存在的较大的晶粒;氧压为2.0 × 10−3 Pa图1(d)和5.0 × 10−3 Pa图1(e)的样品表面以大晶粒为主,均匀性明显比图1(a),图1(b),图1(c)要差,但5.0 × 10−3 Pa图1(e)的均匀性要好于2.0 × 10−3 Pa的样品d。图1(f)显示了生长氧压为1.0 × 10−3 Pa时的三维表面结构图,所生长的ZnO薄膜呈现三维的锥形岛状生长,虽然不是最佳的二维层状生长模式,但表面较为平整,结晶质量较高。
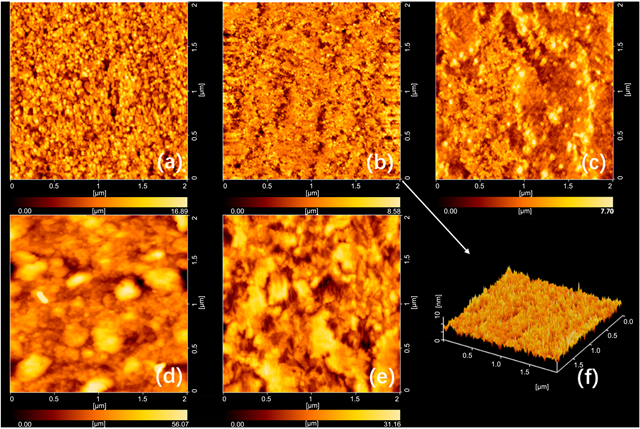
Figure 1. AFM results for ZnO films with growth pressure of (a) 0.6 × 10−3 Pa; (b) 1.0 × 10−3 Pa; (c) 1.5 × 10−3 Pa; (d) 2.0 × 10−3 Pa; (e) 5.0 × 10−3 Pa; (e) 3D AFM view of ZnO with the growth pressure of 1.0 × 10−3 Pa
图1. 生长氧分压分别为(a) 0.6 × 10−3 Pa; (b) 1.0 × 10−3 Pa; (c) 1.5 × 10−3 Pa; (d) 2.0 × 10−3 Pa; (e) 5.0 × 10−3 Pa五个样品的AFM测试结果;(f)生长氧分压为1.0 × 10−3 Pa的ZnO薄膜的三维形貌
图2(a)~(e)为AFM的一维横截面图,可以看出,五个样品均有比较多的沟壑产生,样品a的深度约为10 nm,样品b和样品c的深度约为5 nm,样品d的深度约为60 nm,样品e的深度约为20 nm,这可能是由于低温生长,分子自由能较小,位错多,从而产生了沟渠与孔洞。从图中可以看出,样品的表面一维横截面起伏会随着氧压的变化而改变,随氧分压升高会先减小后增大然后又减小。氧压从0.6 × 10−3 Pa升高到1.5 × 10−3 Pa时,高度起伏逐渐降低,而氧压高于1.5 × 10−3 Pa时,薄膜表面的高度起伏会急剧增大,而当氧压进一步增大达到5.0 × 10−3 Pa时,高度起伏反而减小,但仍然比低氧压环境的样品要大。图2(f)为ZnO薄膜的均方根粗糙度(RMS)随生长氧压的变化情况,五个样品的RMS分别为:2.682 nm/1.209 nm/1.225 nm/8.340 nm/5.145 nm。可以看出随着氧压的变化,ZnO薄膜的表面粗糙度是先减小后增大的,在氧压为1.0 × 10−3 Pa时薄膜的平整度最佳,而不是氧压越高平整度越高。1.5 × 10−3 Pa是一个转折点,氧压高于1.5 × 10−3 Pa时,薄膜的均方根粗糙度(RMS)明显上升,当氧压为2.0 × 10−3 Pa时ZnO 薄膜的粗糙度最大,不同的氧压对生长情况影响明显,其中在氧压为1.0 × 10−3 Pa时,样品表面原子排列均匀且原子尺寸较小。

Figure 2. One-dimensional cross-sectional view for ZnO films with growth pressure of (a) 0.6 × 10−3 Pa; (b) 1.0 × 10−3 Pa; (c) 1.5 × 10−3 Pa; (d) 2.0 × 10−3 Pa; (e) 5.0 × 10−3 Pa; (e) RMS with different growth pressures
图2. 生长氧分压分别为(a) 0.6 × 10−3 Pa; (b) 1.0 × 10−3 Pa; (c) 1.5 × 10−3 Pa; (d) 2.0 × 10−3 Pa; (e) 5.0 × 10−3 Pa的AFM一维横截面图;(f)不同生长氧分压对应的RMS变化情况
由于衬底MgO 是立方相结构,而且ZnO与MgO存在很大的晶格失配,所以外延出来的ZnO薄膜在异质界面处会存在很大的应力,为了将应力减少到最小,生长出的薄膜容易出现多个取向。图3展示了在MgO(110)衬底上外延ZnO薄膜的X射线衍射图。从XRD图中我们很容易看出,只改变生长氧分压这一个条件,而其他条件相同的话,薄膜生长取向随着氧分压的变化而变化。在氧分压比较低的情况下(0.6 × 10−3 Pa和1.0 × 10−3 Pa),薄膜在2 theta = 62.5˚附近有明显的衍射峰,由于衬底MgO(110)的峰位(2 theta = 62.302˚)与ZnO(
)的峰位(2 theta = 62.852˚)太过接近,所以我们仅能通过峰的相对位置判断ZnO(
)峰的强度,在氧分压1.0 × 10−3 Pa条件下生长的样品b的薄膜峰的2 theta更接近62.852˚,可以推测此时薄膜主要沿着ZnO(
)方向(2 theta = 62.852˚)生长。随着生长氧分压的增加,1.5 × 10−3 Pa和2.0 × 10−3 Pa的样品在2 theta = 56.6˚附近可以看到ZnO(
)的衍射峰明显增强,此时薄膜主要沿着ZnO(
)方向(2 theta = 66.592˚)生长,而62˚附近的峰值减弱,半高宽明显增大,表明样品的结晶质量要差于低氧压下生长的样品。当氧分压升高到5.0 × 10−3 Pa时,ZnO(
)和ZnO(
)两组取向同时存在。值得注意的是,样品c和样品d在2theta = 61˚附近均出现了一个小峰,这是立方相ZnO(220)的衍射峰,表明在相应的氧分压下,所生长的薄膜存在立方相结构的ZnO。据我们所知,MgO晶体表面Mg原子的吸附能很小(~0.45 eV) [12] ,因此,在ZnO/MgO界面处不可避免地会出现扩散,改变了界面处ZnO薄膜的结构,其详细机理还有待进一步研究。
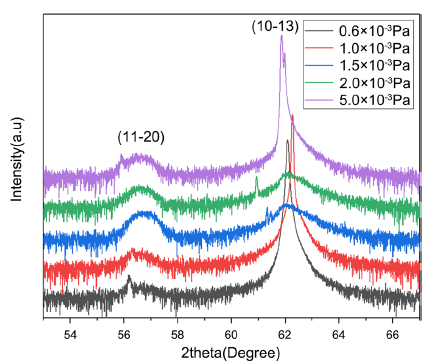
Figure 3. XRD results for ZnO films with different growth pressure
图3. 不同氧分压下生长的ZnO薄膜的XRD结果
图4显示了不同氧分压下生长的ZnO薄膜的吸光度分析。ZnO的主要吸收边在360至400 nm之间。我们可以观察到随着生长气压的增加,吸光度也增加,但当氧分压为1.0 × 10−3 Pa时,吸收减少。可能的解释是通过形态转换减少了吸收。显然,氧分压为5.0 × 10−3 Pa时制备的氧化锌薄膜具有最佳的吸收性能。
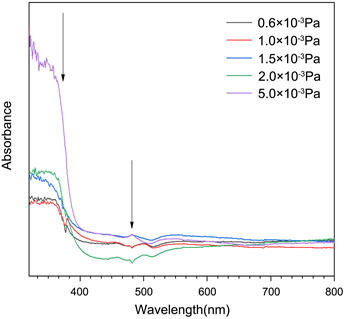
Figure 4. UV-Vis results for ZnO films with different growth pressure
图4. 不同氧分压下生长的ZnO薄膜的UV-Vis结果
由图2可知,在氧压为1.0 × 10−3 Pa时,所生长的ZnO薄膜的RMS值最小,因此我们对生长氧分压为1.0 × 10−3 Pa的样品b做了XRD极图扫描,表征了ZnO(103)面,如图5所示。做极图扫描实验时,选定所要探测的反射峰的2 theta角度,逐步改变ψ角和φ角的值,进行空间立体扫描,可在二维的极射赤面投影图中表示晶体在三维空间中的取向分布。

Figure 5. XRD pole figures from the (103) reflections of the ZnO film
图5. ZnO薄膜的XRD极射赤面投影图
(103)平面的极图显示了11个衍射斑点,如图3中的红色箭头所示,除中心处(
)的极点外,其余10个极点呈对称结构,表明ZnO薄膜中存在两组对称的结构。中心处的(
)极点表明薄膜沿(
)面生长,而不是通常情况下的(0002)面。
假设图5中φ约等于25˚的极点来自(
)ZnO-I/(
)ZnO-I平面的衍射,并且φ约等于205˚的极点来自(
)ZnO-II/(
)ZnO-II平面的衍射。根据(103)ZnO极图的分析(表1),图5中56˚,90˚,124˚,155˚,234.4˚,269.8˚,303.5˚,334˚的其他极点分别来自于(
)ZnO-I/(
)ZnO-I,(
)ZnO-I/(
)ZnO-I,(
)ZnO-I/(
)ZnO-I,(
)ZnO-I/(
)ZnO-I,(
)ZnO-II/(
)ZnO-II,(
)ZnO-II/(
)ZnO-II,(
)ZnO-II/(
)ZnO-II,(
)ZnO-II/(
)ZnO-II各面的衍射。

Table 1. Detail results of the pole figure along (103) ZnO (2 theta = 62.91˚)
表1. XRD极射图的详细结果
4. 结论和展望
我们考察了ZnO薄膜在MgO(110)衬底上的生长行为,发现生长氧分压对ZnO薄膜的表面平整度有一定的影响:在240℃的温度条件下,会随着氧分压的升高而更加平整,超过1.5 × 10−3 Pa时,会随着氧分压的升高而越来越粗糙,在2.0 × 10−3 Pa薄膜表面均方根粗糙度可达8.34 nm。但薄膜的光学特性受生长氧分压的影响较小,在5.0 × 10−3 Pa时,制备的ZnO薄膜吸光度有明显增强,具有最佳的吸收性能。通过XRD观察薄膜取向的改变,通过分析发现,在氧分压比较低的情况下(0.6 × 10−3 Pa和1.0 × 10−3 Pa)薄膜主要沿着ZnO( )方向(2 theta = 62.852˚)生长。随着生长氧分压的增加,1.5 × 10−3 Pa和2.0 × 10−3 Pa的样品主要沿着ZnO(
)方向(2 theta = 66.592˚)生长,而当氧分压升高到5.0 × 10−3 Pa时,ZnO(
)和ZnO(
)两组取向同时存在。XRD-极图结果表明,由于薄膜与衬底间具有高的晶格失配,改变了ZnO的c轴择优取向,在240℃,1.0 × 10−3 Pa的条件下生长出了较为平整的(
)取向的薄膜。此外,XRD结果表明,所生长的ZnO薄膜出现了立方相结构,生长氧分压可能是影响这一现象的重要因素之一。
)方向(2 theta = 62.852˚)生长。随着生长氧分压的增加,1.5 × 10−3 Pa和2.0 × 10−3 Pa的样品主要沿着ZnO(
)方向(2 theta = 66.592˚)生长,而当氧分压升高到5.0 × 10−3 Pa时,ZnO(
)和ZnO(
)两组取向同时存在。XRD-极图结果表明,由于薄膜与衬底间具有高的晶格失配,改变了ZnO的c轴择优取向,在240℃,1.0 × 10−3 Pa的条件下生长出了较为平整的(
)取向的薄膜。此外,XRD结果表明,所生长的ZnO薄膜出现了立方相结构,生长氧分压可能是影响这一现象的重要因素之一。
致谢
感谢台湾高雄中山大学提供仪器设备供本文章做极图测试。
NOTES
*通讯作者。